
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe в производстве микросхем: профессиональный новостной репортаж
Эволюция полупроводниковых материалов
В сфере современной полупроводниковой технологии неустанное стремление к миниатюризации раздвинуло границы традиционных материалов на основе кремния. Чтобы удовлетворить требования к высокой производительности и низкому энергопотреблению, SiGe (кремний-германий) стал предпочтительным композитным материалом в производстве полупроводниковых чипов благодаря своим уникальным физическим и электрическим свойствам. Эта статья углубляется впроцесс эпитаксииSiGe и его роль в эпитаксиальном росте, применении напряженного кремния и структурах Gate-All-Around (GAA).
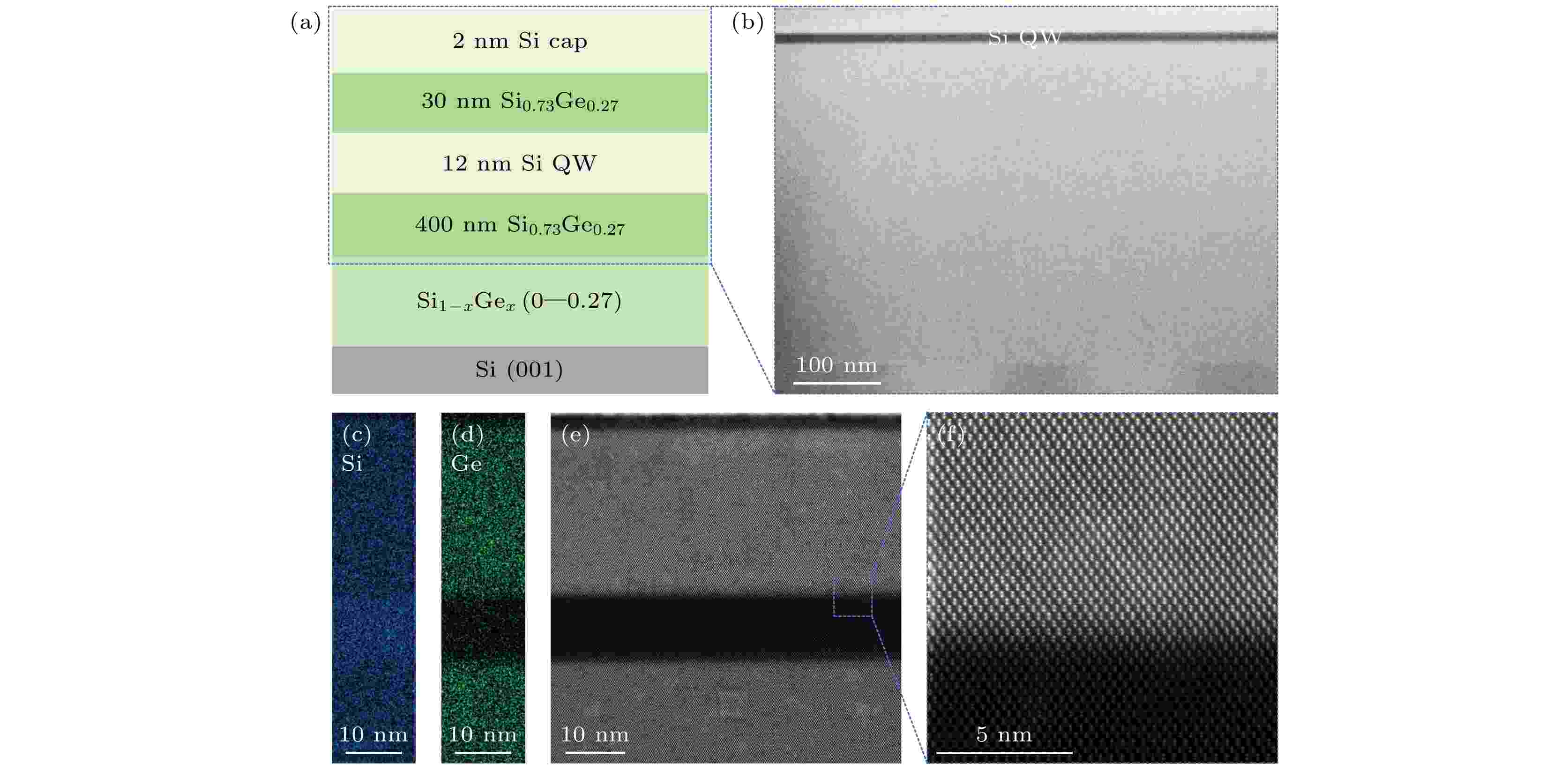
Значение SiGe-эпитаксии
1.1 Введение в эпитаксию при производстве чипов:
Эпитаксия, часто сокращенно называемая Эпи, относится к выращиванию монокристаллического слоя на монокристаллической подложке с таким же расположением решетки. Этот слой может быть либогомоэпитаксиальный (например, Si/Si)или гетероэпитаксиальный (например, SiGe/Si или SiC/Si). Для эпитаксиального роста используются различные методы, в том числе молекулярно-лучевая эпитаксия (MBE), химическое осаждение из паровой фазы в сверхвысоком вакууме (UHV/CVD), эпитаксия при атмосферном давлении и при пониженном давлении (ATM и RP Epi). В данной статье основное внимание уделяется процессам эпитаксии кремния (Si) и кремния-германия (SiGe), широко используемых в производстве полупроводниковых интегральных схем с кремнием в качестве материала подложки.
1.2 Преимущества SiGe-эпитаксии:
Введение определенной доли германия (Ge) во времяпроцесс эпитаксииобразует монокристаллический слой SiGe, который не только уменьшает ширину запрещенной зоны, но и увеличивает частоту среза транзистора (fT). Это делает его широко применимым в высокочастотных устройствах беспроводной и оптической связи. Более того, в усовершенствованных процессах интегральных схем КМОП несоответствие решеток (около 4%) между Ge и Si создает напряжение решетки, увеличивая подвижность электронов или дырок и, таким образом, увеличивая ток насыщения устройства и скорость отклика.
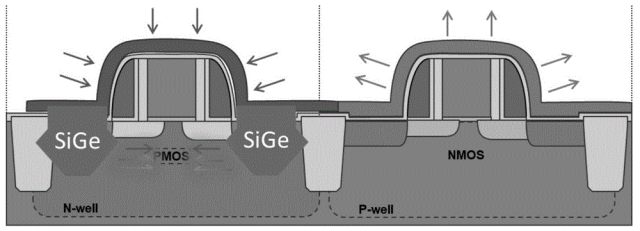
Комплексная схема процесса SiGe-эпитаксии
2.1 Предварительная обработка:
Кремниевые пластины предварительно обрабатываются в зависимости от желаемых результатов процесса, в первую очередь, включая удаление слоя естественного оксида и примесей с поверхности пластины. Для сильнолегированных пластин-подложек крайне важно рассмотреть вопрос о необходимости обратной запайки для уменьшения автолегирования во время последующих операций.эпитаксия рост.
2.2 Ростовые газы и условия:
Кремниевые газы: силан (SiH₄), дихлорсилан (DCS, SiH₂Cl₂) и трихлорсилан (TCS, SiHCl₃) являются тремя наиболее часто используемыми источниками кремниевого газа. SiH₄ подходит для низкотемпературных процессов полной эпитаксии, тогда как TCS, известный своей быстрой скоростью роста, широко используется для приготовления толстыхкремниевая эпитаксияслои.
Газообразный германий: Германий (GeH₄) является основным источником добавления германия, который используется вместе с источниками кремния для формирования сплавов SiGe.
Селективная эпитаксия: селективный рост достигается за счет регулирования относительных скоростейэпитаксиальное осаждениеи травление in situ с использованием хлорсодержащего газообразного кремния DCS. Селективность обусловлена меньшей адсорбцией атомов Cl на поверхности кремния, чем на оксидах или нитридах, что облегчает эпитаксиальный рост. SiH₄, не имеющий атомов Cl и обладающий низкой энергией активации, обычно применяется только в процессах низкотемпературной полной эпитаксии. Другой широко используемый источник кремния, TCS, имеет низкое давление паров и является жидким при комнатной температуре, поэтому для введения его в реакционную камеру требуется барботирование H₂. Однако он относительно недорог и часто используется из-за его высокой скорости роста (до 5 мкм/мин) для выращивания более толстых эпитаксионных слоев кремния, широко применяемых при производстве кремниевых эпитаксионных пластин.
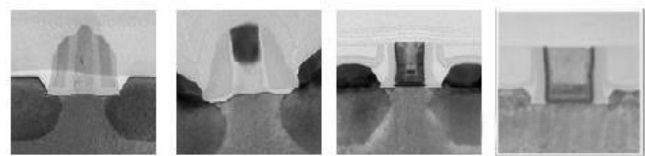
Напряженный кремний в эпитаксиальных слоях
В течениеэпитаксиальный ростЭпитаксиальный монокристалл Si осаждается на релаксированный слой SiGe. Из-за несоответствия решеток Si и SiGe монокристаллический слой Si подвергается растягивающему напряжению со стороны нижележащего слоя SiGe, что значительно увеличивает подвижность электронов в NMOS-транзисторах. Эта технология не только увеличивает ток насыщения (Idsat), но и повышает скорость отклика устройства. В устройствах PMOS слои SiGe эпитаксиально выращиваются в областях истока и стока после травления, чтобы создать сжимающее напряжение в канале, повысить подвижность дырок и увеличить ток насыщения.
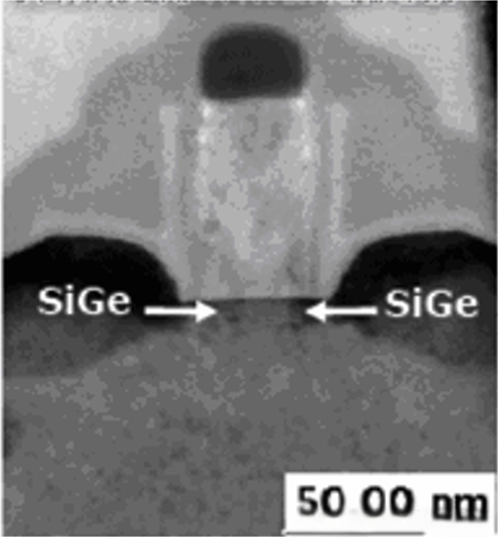
SiGe как жертвенный слой в структурах GAA
При производстве нанопроволочных транзисторов с круговым затвором (GAA) слои SiGe действуют как жертвенные слои. Методы высокоселективного анизотропного травления, такие как травление квазиатомных слоев (квази-ALE), позволяют точно удалять слои SiGe с образованием структур нанопроволоки или нанолистов.
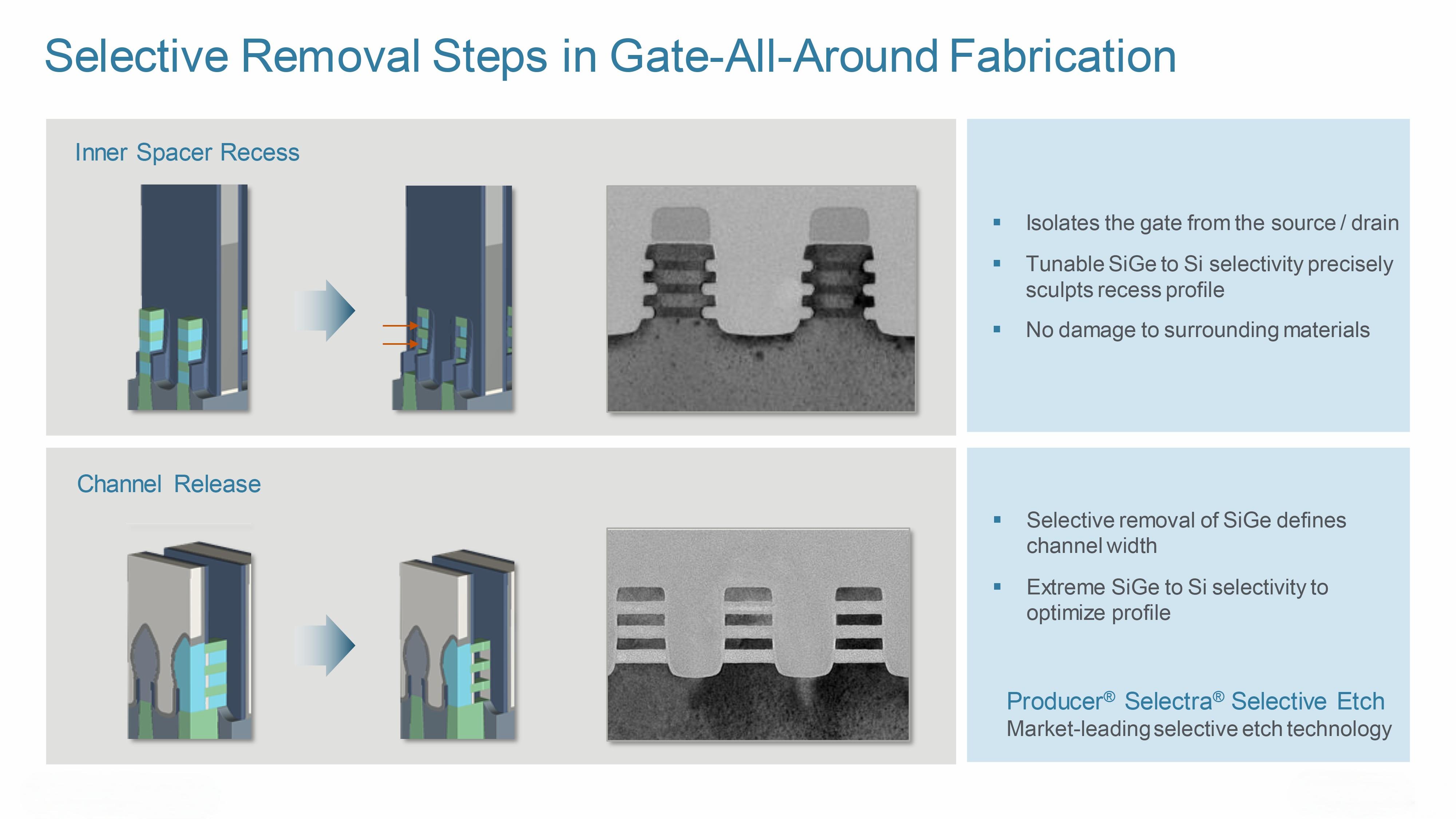
Мы в Semicorex специализируемся наГрафитовые решения с покрытием SiC/TaCприменяется при эпитаксиальном росте кремния в производстве полупроводников. Если у вас есть какие-либо вопросы или вам нужна дополнительная информация, пожалуйста, не стесняйтесь обращаться к нам.
Контактный телефон: +86-13567891907
Электронная почта: sales@semicorex.com




