
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Понимание полного процесса изготовления полупроводниковых устройств
1. Фотолитография
Фотолитография, часто синоним создания узоров, является одной из наиболее важных движущих сил быстрого развития полупроводниковых технологий, берущих свое начало в процессах изготовления фотографических пластин в печати. Этот метод позволяет представить любой узор на микро- или нано-масштабе с использованием фоторезист и в сочетании с другими технологическими процессами переносит эти узоры на материалы, реализуя различные конструкции и концепции полупроводниковых материалов и устройств. Источник света, используемый в фотолитографии, напрямую влияет на точность рисунков: от ультрафиолета, глубокого ультрафиолета до рентгеновских лучей и электронных лучей, каждый из которых соответствует возрастающему уровню точности рисунка в указанном порядке.
Стандартный процесс фотолитографии включает подготовку поверхности, адгезию, мягкую термообработку, экспонирование, постэкспозиционную термообработку, проявление, твердую термообработку и проверку.
Обработка поверхности необходима, поскольку подложки обычно поглощают молекулы H2O из воздуха, что вредно для фотолитографии. Поэтому субстраты первоначально подвергаются обезвоживающей обработке посредством обжига.
Для гидрофильных подложек их адгезия к гидрофобному фоторезисту недостаточна, что потенциально может вызвать отслоение фоторезиста или смещение рисунка, что приводит к необходимости использования промотора адгезии. В настоящее время широко используются усилители адгезии гексаметилдисилазан (ГМДС) и триметилсилилдиэтиламин (ТМСДЭА).
После обработки поверхности начинается нанесение фоторезиста. Толщина нанесенного фоторезиста связана не только с его вязкостью, но также зависит от скорости вращения покрытия, которая обычно обратно пропорциональна квадратному корню из скорости вращения. После нанесения покрытия проводится мягкий обжиг для испарения растворителя из фоторезиста, улучшая адгезию в процессе, известном как предварительный обжиг.
Как только эти шаги будут завершены, происходит экспонирование. Фоторезисты подразделяются на положительные и отрицательные, обладающие противоположными свойствами после экспонирования.
В качестве примера возьмем позитивный фоторезист, где неэкспонированный фоторезист нерастворим в проявителе, но становится растворимым после экспонирования. Во время экспонирования источник света, проходя через узорчатую маску, освещает подложку с покрытием, формируя рисунок фоторезиста. Обычно подложку необходимо выровнять по маске перед экспонированием, чтобы точно контролировать положение экспонирования. Продолжительность воздействия должна строго контролироваться, чтобы предотвратить искажение рисунка. После воздействия может потребоваться дополнительное пропекание для смягчения эффектов стоячей волны, хотя этот шаг не является обязательным и его можно обойти в пользу прямого проявления. Проявление растворяет экспонированный фоторезист, точно перенося рисунок маски на слой фоторезиста. Время разработки также имеет решающее значение: слишком короткое приводит к неполному развитию, слишком долгое вызывает искажение модели.
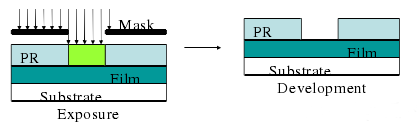
Впоследствии твердая сушка усиливает крепление пленки фоторезиста к подложке и повышает ее стойкость к травлению. Температура жесткого выпекания обычно немного выше, чем температура предварительного выпекания.
Наконец, микроскопический осмотр проверяет, соответствует ли картина ожиданиям. После того, как рисунок перенесен на материал другими процессами, фоторезист выполнил свою задачу и его необходимо удалить. Методы удаления включают влажный (с использованием сильных органических растворителей, таких как ацетон) и сухой (с использованием кислородной плазмы для травления пленки).
2. Методы допинга
Легирование незаменимо в полупроводниковой технологии, изменяя электрические свойства полупроводниковых материалов по мере необходимости. Обычные методы легирования включают термодиффузию и ионную имплантацию.
(1) Ионная имплантация
Ионная имплантация легирует полупроводниковую подложку путем бомбардировки ее ионами высокой энергии. По сравнению с термодиффузией он имеет много преимуществ. Ионы, отобранные масс-анализатором, обеспечивают высокую чистоту легирования. На протяжении всей имплантации температура субстрата остается комнатной или чуть выше. Можно использовать множество маскирующих пленок, таких как диоксид кремния (SiO2), нитрид кремния (Si3N4) и фоторезист, что обеспечивает высокую гибкость при использовании методов самовыравнивающейся маски. Дозы имплантатов точно контролируются, а распределение ионов имплантированных примесей однородно в одной плоскости, что обеспечивает высокую повторяемость.
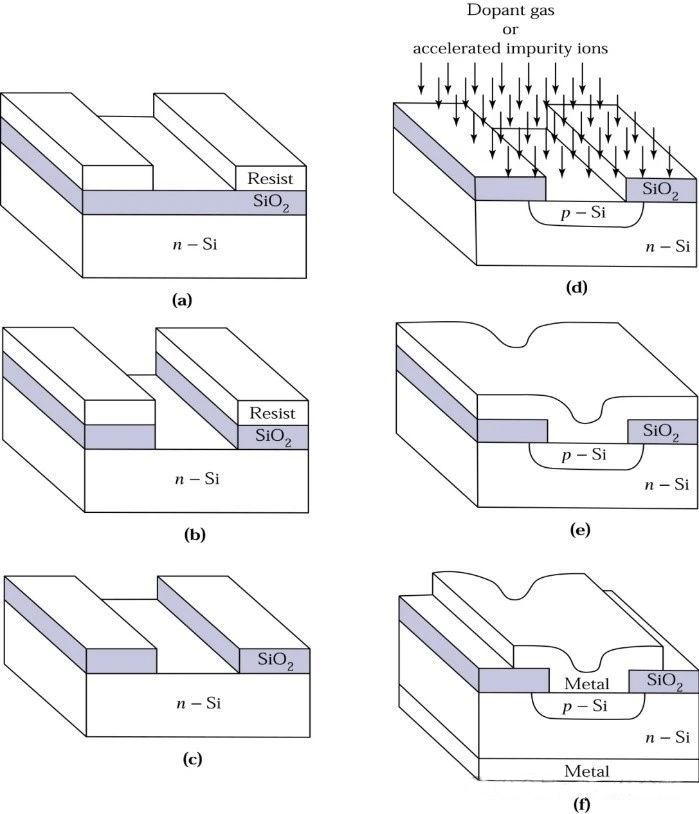
Глубина имплантации определяется энергией ионов. Регулируя энергию и дозу, можно манипулировать распределением ионов примесей в подложке после имплантации. Множественные имплантации по различным схемам могут выполняться непрерывно для достижения различных профилей примесей. Примечательно, что в монокристаллических подложках, если направление имплантации параллельно кристаллографическому направлению, возникают эффекты каналирования — некоторые ионы будут перемещаться вдоль каналов, что затрудняет контроль глубины.
Чтобы предотвратить образование каналов, имплантацию обычно проводят под углом около 7° к главной оси монокристаллической подложки или путем покрытия подложки аморфным слоем.
Однако ионная имплантация может существенно повредить кристаллическую структуру подложки. Ионы высокой энергии при столкновении передают энергию ядрам и электронам подложки, заставляя их покидать решетку и образовывать пары дефектов межузель-вакансия. В тяжелых случаях кристаллическая структура на некоторых участках может разрушаться, образуя аморфные зоны.
Повреждение решетки сильно влияет на электрические свойства полупроводникового материала, например, уменьшая подвижность носителей или время жизни неравновесных носителей. Самое главное, что большинство имплантированных примесей занимают межузельные участки неправильной формы, не образуя эффективного легирования. Поэтому восстановление постимплантационных повреждений решетки и электрическая активация примесей имеют важное значение.
(2)Быстрая термическая обработка (RTP)
Термический отжиг является наиболее эффективным методом устранения повреждений решетки, вызванных ионной имплантацией и электрически активирующими примесями. При высоких температурах пары дефектов межузель-вакансия в кристаллической решетке подложки рекомбинируют и исчезают; аморфные области также будут рекристаллизоваться от границы с монокристаллическими областями посредством твердофазной эпитаксии. Чтобы предотвратить окисление материала подложки при высоких температурах, термический отжиг необходимо проводить в вакууме или атмосфере инертного газа. Традиционный отжиг занимает много времени и может вызвать значительное перераспределение примесей за счет диффузии.
ПоявлениеТехнология RTPрешает эту проблему, в основном выполняя восстановление повреждений решетки и активацию примесей за сокращенную продолжительность отжига.
В зависимости от источника тепла,RTPподразделяется на несколько типов: сканирование электронным лучом, импульсные электронные и ионные пучки, импульсные лазеры, лазеры непрерывного действия и широкополосные источники некогерентного света (галогенные лампы, графитовые нагреватели, дуговые лампы), причем последние получили наиболее широкое распространение. Эти источники могут мгновенно нагреть подложку до необходимой температуры, за короткое время завершить отжиг и эффективно уменьшить диффузию примесей.
3. Методы нанесения пленки
(1) Химическое осаждение из паровой фазы, усиленное плазмой (PECVD)
PECVD — это одна из форм химического осаждения из паровой фазы (CVD) для осаждения пленки, две другие — CVD при атмосферном давлении (APCVD) и CVD при низком давлении (LPCVD).
В настоящее время из трех типов наиболее широко применяется PECVD. Он использует радиочастотную (РЧ) плазму для инициирования и поддержания химических реакций при относительно низких температурах, что способствует низкотемпературному осаждению пленки с высокой скоростью осаждения. Схема его оборудования показана на рисунке.
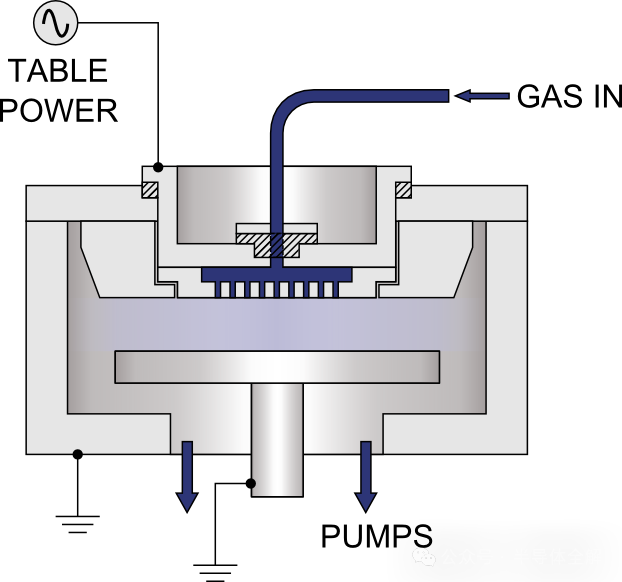
Пленки, полученные этим методом, демонстрируют исключительные адгезионные и электрические свойства, минимальную микропористость, высокую однородность и надежную способность к мелкомасштабному заполнению. Факторы, влияющие на качество PECVD-осаждения, включают температуру подложки, скорость потока газа, давление, мощность радиочастотного излучения и частоту.
(2) Напыление
Напыление — это метод физического осаждения из паровой фазы (PVD). Заряженные ионы (обычно ионы аргона, Ar+) ускоряются в электрическом поле, приобретая кинетическую энергию. Они направляются к целевому материалу, сталкиваясь с целевыми молекулами и заставляя их смещаться и распыляться. Эти молекулы также обладают значительной кинетической энергией и движутся к подложке, осаждаясь на ней.

Обычно используемые источники питания для распыления включают постоянный ток (DC) и радиочастоту (RF), где распыление постоянным током непосредственно применимо к проводящим материалам, таким как металлы, в то время как изоляционные материалы требуют радиочастотного распыления для осаждения пленки.
Обычное напыление страдает от низкой скорости осаждения и высокого рабочего давления, что приводит к снижению качества пленки. Магнетронное распыление лучше всего решает эти проблемы. Он использует внешнее магнитное поле для изменения линейной траектории ионов на спиральную траекторию вокруг направления магнитного поля, удлиняя их путь и повышая эффективность столкновения с целевыми молекулами, тем самым повышая эффективность распыления. Это приводит к увеличению скорости осаждения, снижению рабочего давления и значительному улучшению качества пленки.
4. Травление Техники
Травление подразделяется на сухой и мокрый режимы, названные в честь использования (или отсутствия) конкретных растворов соответственно.
Обычно травление требует подготовки маскирующего слоя (который может быть непосредственно фоторезистом) для защиты участков, не предназначенных для травления.
(1) Сухое травление
Распространенные типы сухого травления включаютТравление в индуктивно-связанной плазме (ИСП), ионно-лучевое травление (IBE) и реактивное ионное травление (RIE).
При ICP-травлении плазма, создаваемая тлеющим разрядом, содержит множество высокохимически активных свободных радикалов (свободные атомы, молекулы или атомные группы), которые химически реагируют с материалом мишени с образованием летучих продуктов, что обеспечивает травление.
IBE использует ионы высокой энергии (ионизированные из инертных газов) для прямой бомбардировки поверхности целевого материала для травления, что представляет собой физический процесс.
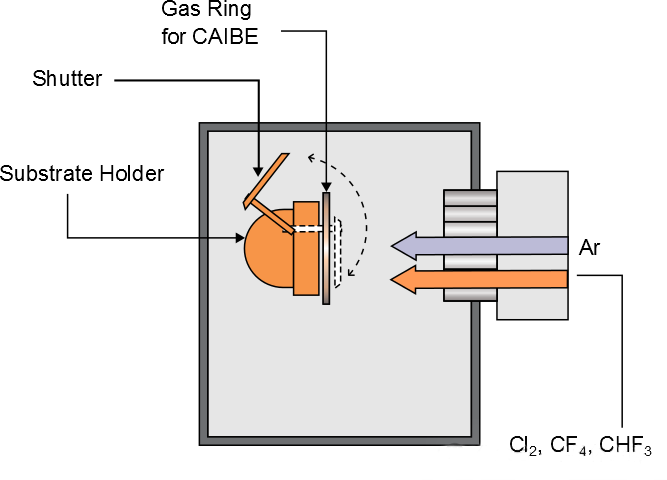
RIE считается комбинацией двух предыдущих, заменяя инертный газ, используемый в IBE, газом, используемым при травлении ICP, тем самым образуя RIE.
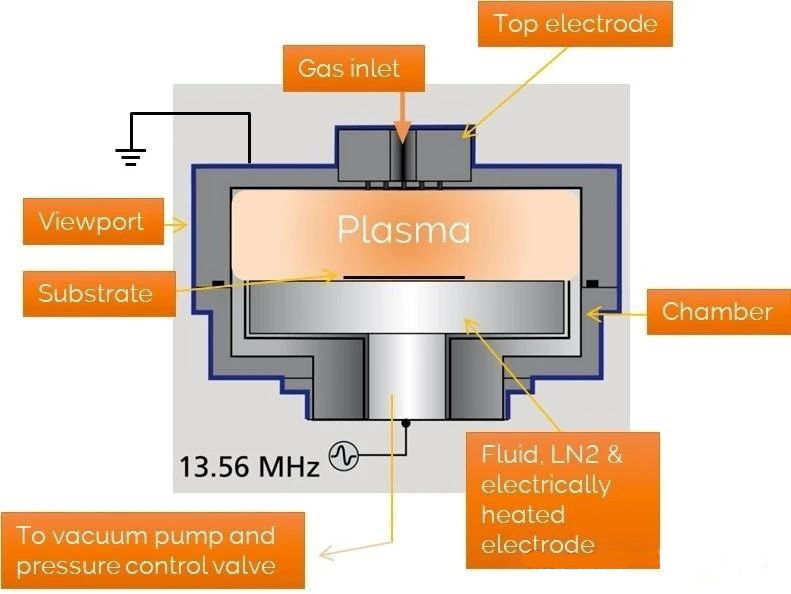
При сухом травлении скорость вертикального травления намного превышает скорость латерального травления, т. е. оно имеет высокое соотношение сторон, что позволяет точно воспроизвести рисунок маски. Однако сухое травление также травит маскирующий слой, демонстрируя меньшую селективность (отношение скоростей травления целевого материала к маскирующему слою), особенно при IBE, который может неселективно травить поверхность материала.
(2) Влажное травление
Мокрое травление означает метод травления, достигаемый путем погружения целевого материала в раствор (травитель), который химически вступает с ним в реакцию.
Этот метод травления прост, экономичен и демонстрирует хорошую селективность, но имеет низкое соотношение сторон. Материал под краями маски может подвергаться коррозии, что делает его менее точным, чем сухое травление. Чтобы смягчить негативное воздействие низкого соотношения сторон, необходимо выбрать соответствующую скорость травления. Факторы, влияющие на скорость травления, включают концентрацию травителя, время травления и температуру травления.**




