
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Плазменные процессы при операциях CVD
1. Очистка камеры
В процессе химического осаждения из паровой фазы (CVD) отложения образуются не только на поверхности пластины, но также на компонентах внутри технологической камеры и ее стенок. Пленки, нанесенные на детали, необходимо регулярно удалять для поддержания стабильных условий процесса и предотвращения загрязнения пластин частицами. В большинстве камер CVD для очистки используются газы химической реакции на основе фтора.
В камерах CVD на основе оксида кремния при плазменной очистке обычно используются фторуглеродные газы, такие как CF4, C2F6 и C3F8, которые разлагаются в плазме, выделяя радикалы фтора. Химические реакции представлены следующим образом:
·е- + CF4 -> CF3 + F + е-
· е- + C2F6 -> C2F5 + F + е-
Атомы фтора, являясь одними из наиболее реакционноспособных радикалов, быстро реагируют с оксидом кремния с образованием газообразного SiF4, который легко откачивается из камеры:
·F + SiO2 -> SiF4 + O2 + другие летучие побочные продукты
Вольфрамовые камеры CVD обычно используют SF6 и NF3 в качестве источников фтора. Радикалы фтора реагируют с вольфрамом с образованием летучего гексафторида вольфрама (WF6), который можно откачать из камеры с помощью вакуумных насосов. Очистка плазменной камеры может быть прекращена автоматически путем контроля характеристик эмиссии фтора в плазме, что позволяет избежать чрезмерной очистки камеры. Эти аспекты будут рассмотрены более подробно.
2. Заполнение пробелов
Когда зазор между линиями металла сужается до 0,25 мкм при соотношении сторон 4:1, большинство методов CVD-осаждения с трудом заполняют зазоры без пустот. Плазменный CVD высокой плотности (HDP-CVD) способен заполнять такие узкие зазоры, не создавая пустот (см. рисунок ниже). Процесс HDP-CVD будет описан далее.
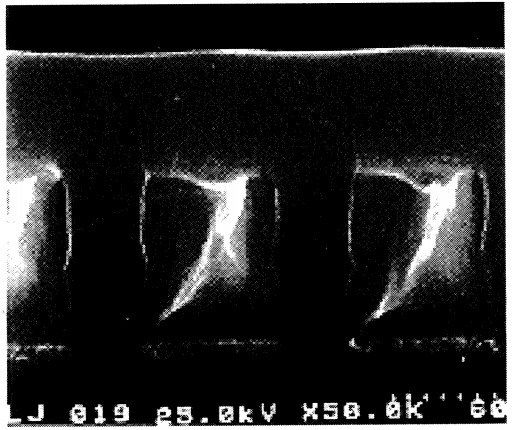
3. Плазменное травление
По сравнению с мокрым травлением плазменное травление предлагает такие преимущества, как анизотропные профили травления, автоматическое определение конечной точки и более низкий расход химикатов, а также разумно высокие скорости травления, хорошую селективность и однородность.
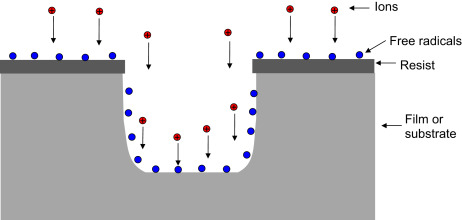
4. Управление профилями травления
До того, как плазменное травление стало широко распространено в производстве полупроводников, большинство производителей пластин использовали влажное химическое травление для переноса рисунка. Однако мокрое травление представляет собой изотропный процесс (травление с одинаковой скоростью во всех направлениях). Когда размеры элементов уменьшаются ниже 3 мкм, изотропное травление приводит к подрезу, что ограничивает применение влажного травления.
В плазменных процессах ионы непрерывно бомбардируют поверхность пластины. Будь то механизмы повреждения решетки или механизмы пассивации боковых стенок, плазменное травление позволяет добиться анизотропных профилей травления. Уменьшая давление во время процесса травления, можно увеличить среднюю длину свободного пробега ионов, тем самым уменьшая столкновения ионов и улучшая контроль профиля.
5. Скорость травления и селективность
Ионная бомбардировка в плазме помогает разорвать химические связи поверхностных атомов, подвергая их воздействию радикалов, генерируемых плазмой. Такое сочетание физической и химической обработки значительно повышает скорость химической реакции травления. Скорость травления и селективность определяются требованиями процесса. Поскольку и ионная бомбардировка, и радикалы играют решающую роль в травлении, а радиочастотная мощность может контролировать ионную бомбардировку и радикалы, радиочастотная мощность становится ключевым параметром для управления скоростью травления. Увеличение ВЧ-мощности может значительно повысить скорость травления, что будет обсуждаться более подробно и также влиять на селективность.
6. Обнаружение конечной точки
Без плазмы конечная точка травления должна определяться по времени или визуальному осмотру оператора. В плазменных процессах, когда травление проходит через поверхностный материал и начинает травить основной (конечный) материал, химический состав плазмы изменяется из-за изменения побочных продуктов травления, что проявляется в изменении цвета излучения. Контролируя изменение цвета излучения с помощью оптических датчиков, можно автоматически обработать конечную точку травления. В производстве микросхем это очень ценный инструмент.**




