
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Дислокации в кристаллах SiC
Подложка SiC может иметь микроскопические дефекты, такие как дислокация резьбового винта (TSD), дислокация края резьбы (TED), дислокация базовой плоскости (BPD) и другие. Эти дефекты вызваны отклонениями в расположении атомов на атомном уровне.
Кристаллы SiC обычно растут параллельно оси c или под небольшим углом к ней, что означает, что плоскость c также известна как базовая плоскость. В кристалле различают два основных типа дислокаций. Когда линия дислокации перпендикулярна базовой плоскости, кристалл наследует дислокации из затравочного кристалла в эпитаксиально выращенный кристалл. Эти дислокации известны как проникающие дислокации и могут быть разделены на резьбовые краевые дислокации (TED) и резьбовые винтовые дислокации (TSD) в зависимости от ориентации вектора Бернулли к линии дислокации. Дислокации, в которых и линии дислокаций, и векторы Бренстеда находятся в базовой плоскости, называются дислокациями базовой плоскости (ДПД). Кристаллы SiC также могут иметь составные дислокации, представляющие собой комбинацию перечисленных выше дислокаций.
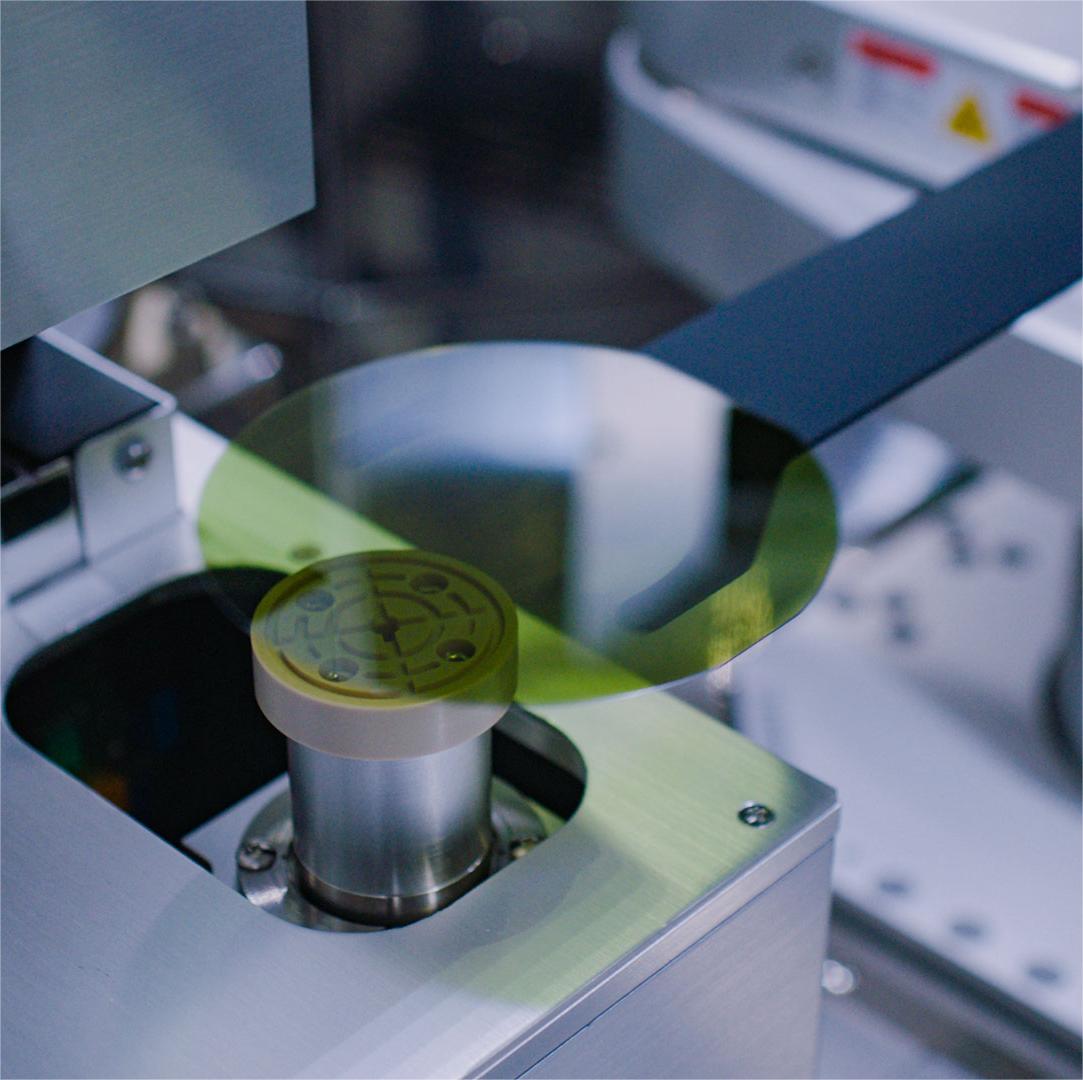
1. ТЕД&ТСД
Как резьбовые дислокации (TSD), так и резьбовые краевые дислокации (TED) проходят вдоль оси роста [0001] с различными векторами Бюргерса <0001> и 1/3<11-20> соответственно.
И TSD, и TED могут простираться от подложки до поверхности пластины и образовывать небольшие ямки на поверхности. Обычно плотность ТЭД составляет около 8000-10000 1/см2, что почти в 10 раз превышает плотность ТСД.
В процессе эпитаксиального роста SiC ТСД распространяется от подложки к эпитаксиальному слою, расширенный ТСД может трансформироваться в другие дефекты в плоскости подложки и распространяться вдоль оси роста.
Показано, что в процессе эпитаксиального роста SiC ТСД трансформируется в дефекты слоя упаковки (SF) или морковные дефекты в плоскости подложки, а TED в эпитаксиальном слое трансформируется из BPD, унаследованного от подложки в процессе эпитаксиального роста.
2. БЛД
Базисно-плоские дислокации (БПД), расположенные в плоскости [0001] кристаллов SiC, имеют вектор Бюргерса 1/3 <11-20>.
BPD редко появляются на поверхности пластин SiC. Обычно они концентрируются на подложке с плотностью 1500 1/см2, тогда как их плотность в эпитаксиальном слое составляет всего около 10 1/см2.
Понятно, что плотность BPD уменьшается с увеличением толщины подложки SiC. При исследовании с помощью фотолюминесценции (ФЛ) BPD демонстрируют линейные особенности. В процессе эпитаксиального роста SiC расширенный BPD может трансформироваться в SF или TED.
Из вышеизложенного очевидно, что в пластине-подложке SiC присутствуют дефекты. Эти дефекты могут быть унаследованы при эпитаксиальном росте тонких пленок, что может привести к фатальному повреждению устройства SiC. Это может привести к потере таких преимуществ SiC, как высокое поле пробоя, высокое обратное напряжение и низкий ток утечки. Кроме того, это может снизить уровень квалификации продукта и создать огромные препятствия для индустриализации SiC из-за снижения надежности.




