
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Понимание технологии сухого травления в полупроводниковой промышленности
2024-06-11
Травление относится к методу выборочного удаления материала физическими или химическими средствами для достижения заданных структурных рисунков.
В настоящее время во многих полупроводниковых устройствах используются меза-структуры устройств, которые преимущественно создаются с помощью двух типов травления:влажное травление и сухое травление. Хотя простое и быстрое мокрое травление играет важную роль в изготовлении полупроводниковых приборов, оно имеет присущие ему недостатки, такие как изотропное травление и плохая однородность, что приводит к ограниченному контролю при переносе рисунков небольшого размера. Однако сухое травление с его высокой анизотропией, хорошей однородностью и повторяемостью стало широко использоваться в процессах изготовления полупроводниковых приборов. Термин «сухое травление» в широком смысле относится к любой технологии немокрого травления, используемой для удаления поверхностных материалов и переноса микро- и наноструктур, включая лазерное травление, плазменное травление и химическое травление из паровой фазы. Сухое травление, обсуждаемое в этом тексте, относится конкретно к узкому применению процессов с использованием плазменного разряда — физического или химического — для модификации поверхностей материалов. Он охватывает несколько распространенных технологий промышленного травления, в том числеИонно-лучевое травление (IBE), реактивное ионное травление (RIE), плазменное травление электронного циклотронного резонанса (ECR) и травление индуктивно-связанной плазмой (ICP).
1. Ионно-лучевое травление (IBE)
Метод IBE, также известный как ионное измельчение, был разработан в 1970-х годах как чисто физический метод травления. В этом процессе используются ионные пучки, создаваемые из инертных газов (таких как Ar, Xe), которые ускоряются под действием напряжения и бомбардируют поверхность целевого материала. Ионы передают энергию поверхностным атомам, в результате чего атомы, энергия которых превышает их энергию связи, распыляются. В этом методе используется ускоренное напряжение для управления направлением и энергией ионного пучка, что приводит к превосходной анизотропии травления и управляемости скорости. Хотя он идеально подходит для травления химически стабильных материалов, таких как керамика и некоторые металлы, необходимость в более толстых масках для более глубокого травления может поставить под угрозу точность травления, а бомбардировка ионами высокой энергии может вызвать неизбежные электрические повреждения из-за разрушения решетки.

2. Реактивное ионное травление (РИЭ).
RIE, разработанный IBE, сочетает в себе химические реакции с физической ионной бомбардировкой. По сравнению с IBE, RIE предлагает более высокие скорости травления, отличную анизотропию и однородность на больших площадях, что делает его одним из наиболее широко используемых методов травления в микро- и нанопроизводстве. Этот процесс включает в себя подачу высокочастотного (РЧ) напряжения на параллельные пластинчатые электроды, заставляя электроны в камере ускорять и ионизировать реакционные газы, что приводит к стабильному состоянию плазмы на одной стороне пластин. Плазма несет положительный потенциал из-за того, что электроны притягиваются к катоду и заземляются на аноде, создавая таким образом электрическое поле в камере. Положительно заряженная плазма ускоряется по направлению к подложке, связанной с катодом, эффективно травя ее.
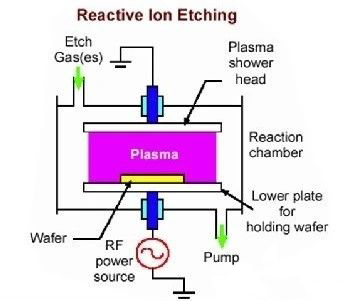
В процессе травления в камере поддерживается среда низкого давления (0,1–10 Па), что повышает скорость ионизации реакционных газов и ускоряет процесс химической реакции на поверхности подложки. Как правило, процесс RIE требует, чтобы побочные продукты реакции были летучими, чтобы их можно было эффективно удалить с помощью вакуумной системы, что обеспечивает высокую точность травления. Уровень радиочастотной мощности напрямую определяет плотность плазмы и напряжение ускоряющего смещения, тем самым контролируя скорость травления. Однако, увеличивая плотность плазмы, RIE также увеличивает напряжение смещения, что может вызвать повреждение решетки и снизить селективность маски, что создает ограничения для приложений травления. С быстрым развитием крупномасштабных интегральных схем и уменьшением размеров транзисторов возрос спрос на точность и соотношение сторон в микро- и нанопроизводстве, что привело к появлению технологий сухого травления на основе плазмы высокой плотности, обеспечивающих новые возможности для развития электронных информационных технологий.
3. Электронно-циклотронный резонанс (ЭЦР) плазменное травление.
Технология ECR, один из первых методов получения плазмы высокой плотности, использует микроволновую энергию для резонанса с электронами внутри камеры, усиливаемую внешним магнитным полем с согласованной частотой для индукции электронного циклотронного резонанса. Этот метод обеспечивает значительно более высокую плотность плазмы, чем RIE, увеличивая скорость травления и селективность маски, тем самым облегчая травление структур со сверхвысоким аспектным соотношением. Однако сложность системы, которая опирается на скоординированную работу микроволновых источников, радиочастотных источников и магнитных полей, создает проблемы в эксплуатации. Вскоре появилось травление индуктивно-связанной плазмой (ICP), ставшее упрощением метода ECR.
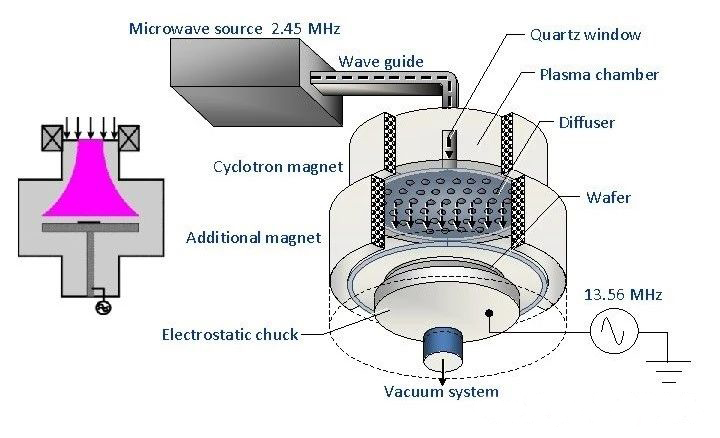
4. Травление в индуктивно-связанной плазме (ИСП)
Технология травления ICP упрощает систему, основанную на технологии ECR, за счет использования двух радиочастотных источников 13,56 МГц для управления как генерацией плазмы, так и напряжением ускоряющего смещения. Вместо внешнего магнитного поля, используемого в ЭЦР, спиральная катушка индуцирует переменное электромагнитное поле, как показано на схеме. Радиочастотные источники передают энергию посредством электромагнитной связи внутренним электронам, которые движутся циклотронно внутри индуцированного поля, сталкиваясь с реакционными газами, вызывая ионизацию. Эта установка обеспечивает плотность плазмы, сравнимую с ЭЦР. ICP-травление сочетает в себе преимущества различных систем травления, удовлетворяя потребности в высоких скоростях травления, высокой селективности, однородности большой площади и простой, управляемой конструкции оборудования, что быстро становится предпочтительным выбором для нового поколения технологий плазменного травления высокой плотности. .
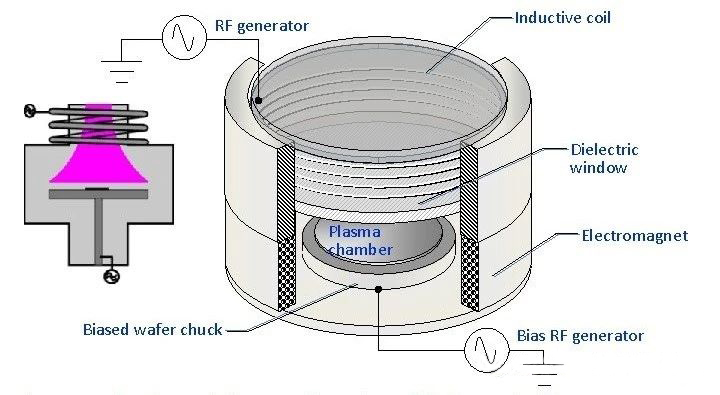
5. Характеристики сухого травления.
Технология сухого травления быстро заняла лидирующие позиции в микро- и нанопроизводстве благодаря своей превосходной анизотропии и высокой скорости травления, заменяя мокрое травление. Критерии оценки хорошей технологии сухого травления включают селективность маски, анизотропию, скорость травления, общую однородность и гладкость поверхности из-за повреждения решетки. При наличии многих критериев оценки конкретная ситуация должна учитываться с учетом производственных потребностей. Наиболее прямыми показателями сухого травления являются морфология поверхности, включая плоскостность протравленного пола и боковых стенок, а также анизотропию протравленных террас, которыми можно управлять, регулируя соотношение химических реакций и физической бомбардировки. Микроскопическая характеристика после травления обычно проводится с использованием сканирующей электронной микроскопии и атомно-силовой микроскопии. Селективность маски, которая представляет собой отношение глубины травления маски к глубине травления материала при одинаковых условиях и времени травления, имеет решающее значение. Как правило, чем выше селективность, тем выше точность передачи рисунка. Обычно маски, используемые при травлении ICP, включают фоторезист, металлы и диэлектрические пленки. Фоторезист обладает плохой селективностью и может разрушаться при высоких температурах или энергичной бомбардировке; металлы обладают высокой селективностью, но создают проблемы при удалении маски и часто требуют применения методов многослойной маскировки. Кроме того, металлические маски могут прилипать к боковым стенкам во время травления, образуя пути утечки. Поэтому выбор подходящей технологии маски особенно важен для травления, а выбор материалов маски должен определяться исходя из конкретных требований к производительности устройств.**




